國(guó)內(nèi)EBL鄰近效應(yīng)修正技術(shù)面臨的挑戰(zhàn)
日期:2025-08-06
EBL憑借電子波長(zhǎng)短,不受衍射限制等優(yōu)勢(shì),對(duì)比光學(xué)光刻具有更高的理論極限分辨率,常被用于掩模版制作和小批量器件研發(fā)制作等領(lǐng)域。不過(guò),區(qū)別于光學(xué)光刻,由于電子束會(huì)在抗蝕劑內(nèi)發(fā)生前散射,且還會(huì)與襯底材料作用發(fā)射背散射,使得電子束作用范圍超出原先設(shè)定區(qū)域,導(dǎo)致圖形分辨率下降,尺寸、形貌異常,這一現(xiàn)象也被廣大研究人員稱(chēng)為鄰近效應(yīng)。
一、鄰近效應(yīng)的發(fā)現(xiàn)及作用原理
高斯束電子束光刻憑借低成本和高分辨率的優(yōu)勢(shì)常被用于微納結(jié)構(gòu)制造[1],早在1975年,T.H.P. Chang就依據(jù)實(shí)驗(yàn)數(shù)據(jù)結(jié)果,提出了高斯分布函數(shù)來(lái)描述高斯束系統(tǒng)的EBL曝光時(shí)電子作用產(chǎn)生的能量分布,這為鄰近效應(yīng)的提出奠定了理論基礎(chǔ)[2]。其實(shí)質(zhì)上由于高能電子束在穿過(guò)抗蝕劑層過(guò)程中發(fā)生的前散射和電子與襯底材料原子的核外電子作用產(chǎn)生的背散射電子所導(dǎo)致的部分電子作用于預(yù)設(shè)范圍外的區(qū)域,使得圖形線寬異常、邊緣分辨率下降的現(xiàn)象[3],其產(chǎn)生原理模擬簡(jiǎn)圖如下圖1所示。
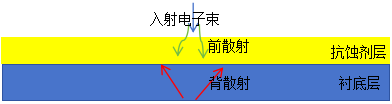
二、鄰近效應(yīng)的修正方法
通常,鄰近效應(yīng)的修正方法包括常用幾何尺寸校正和劑量校正[4],以及應(yīng)用較少的GHOST方法。幾何尺寸校正計(jì)算通過(guò)調(diào)整設(shè)計(jì)圖形的形狀、尺寸等來(lái)改善局部區(qū)域內(nèi)的能量分布,已達(dá)到補(bǔ)償鄰近效應(yīng)帶來(lái)的影響的作用;而劑量校正法則是以Monte Carlo模型或近似函數(shù)擬合模型為主,通過(guò)雙高斯分布函數(shù):(其中α、β分別代指前散射和背散的高斯分布方差,η為兩者的比值)來(lái)描述不同區(qū)域的電子能量沉積分布,再利用計(jì)算機(jī)得到α、β和η的具體值,并代入校正軟件,進(jìn)行計(jì)算得到不同區(qū)域內(nèi)所需的補(bǔ)償劑量值,以降低鄰近效應(yīng)帶來(lái)的副作用。而GHOST方法則是以背散射電子曝光強(qiáng)度的反劑量,利用非聚焦電子束對(duì)非曝光區(qū)域進(jìn)行線掃,使整體圖形擁有相同的背散射作用劑量,僅考慮了背散射電子的影響,只適合超高加速電壓等前提條件下的快捷校正[5]。同時(shí),該方法大多在角度限制散射投影電子束光刻中應(yīng)用,且圖形襯底一般較低[6]。
一般來(lái)說(shuō),目前主流的優(yōu)化方式仍然是劑量校正法,通過(guò)Monte Carlo模型或近似函數(shù)擬合模型,以雙高斯分布函數(shù)為基礎(chǔ),通過(guò)計(jì)算機(jī)模擬預(yù)測(cè)電子能量的沉積分布和調(diào)整各局部區(qū)域曝光劑量的方式,來(lái)優(yōu)化改善圖形內(nèi)的能量分布均勻性[7]。但是該模型的預(yù)測(cè)模型建立中忽略了二次電子等其它因素的影響,所以仍然只是一個(gè)做到大致優(yōu)化的工具,難以做到全面優(yōu)化。且各區(qū)域補(bǔ)償參數(shù)的設(shè)定和計(jì)算還受到例如襯底材料均勻性以及進(jìn)行套刻時(shí)的抗蝕劑材料均勻性、抗蝕劑厚度均勻性等的影響,故此,計(jì)算出來(lái)的補(bǔ)償數(shù)值與實(shí)際所需的補(bǔ)償數(shù)值仍然有一定偏差。所以,一種全新的、更精確的模擬模型的出現(xiàn)對(duì)于鄰近效應(yīng)校正領(lǐng)域的發(fā)展完善而言是迫在眉睫的。
三、鄰近效應(yīng)修正案例
以國(guó)內(nèi)澤攸科技研發(fā)人員進(jìn)行優(yōu)化測(cè)試的一個(gè)棋盤(pán)圖形設(shè)計(jì)為例,該棋盤(pán)單格線寬設(shè)計(jì)為500nm,原材料利用表面涂覆厚度約100nm的PMMA光刻膠的Si片,使用30kV的加速電壓、10μm光闌孔徑進(jìn)行刻寫(xiě)作業(yè),首次刻寫(xiě)時(shí)以100μC/cm2至300μC/cm2為限定區(qū)間,每增加25μC/cm2劑量為一個(gè)組別,不進(jìn)行鄰近效應(yīng)修正,直接曝光,并顯影,利用SEM分析形貌發(fā)現(xiàn)邊緣與中心區(qū)域因電子能量沉積差異,導(dǎo)致其實(shí)際圖形與設(shè)定的棋盤(pán)圖形存在較大異,其中部分曝光劑量下的形貌圖如下圖2所示。從下圖2中我們可以發(fā)現(xiàn),在175μC/cm2劑量下,靠近最中心區(qū)域的圖形因?yàn)殡娮幽芰砍练e不足、相鄰圖形間鄰近效應(yīng)作用小而表現(xiàn)出欠曝現(xiàn)象(黑色部分為殘留光刻膠),圖形尺寸異常偏小,殘留光刻膠過(guò)多,而靠近邊緣的區(qū)域的圖形則電子能量沉積較為充足、相鄰圖形間鄰近效應(yīng)作用較強(qiáng),使得圖形尺寸勉強(qiáng)接近預(yù)設(shè)尺寸,但是最邊緣區(qū)域卻因周?chē)鷪D形區(qū)域太大,電子能量在此區(qū)域沉積過(guò)大,導(dǎo)致圖形尺寸異常偏大。同理,當(dāng)曝光劑量達(dá)到200μC/cm2時(shí),中心區(qū)域因能量沉積加大,圖形表現(xiàn)接近正常尺寸的圖形,靠近邊緣區(qū)域則因能量沉積過(guò)于大而表現(xiàn)出圖形尺寸過(guò)大現(xiàn)象,而最邊緣區(qū)域則因能量沉積繼續(xù)加大,表現(xiàn)出圖形尺寸更大,殘留光刻膠區(qū)域更小的現(xiàn)象。當(dāng)曝光劑量增加至225μC/cm2時(shí),中心區(qū)域也因能量沉積增大,相鄰圖形間鄰近效應(yīng)作用過(guò)強(qiáng)而出現(xiàn)圖形尺寸異常偏大,殘留光刻膠區(qū)域越來(lái)越小,至于靠近邊緣區(qū)域和最邊緣區(qū)域,則是能量沉積進(jìn)一步加大,圖形尺寸進(jìn)一步減小。
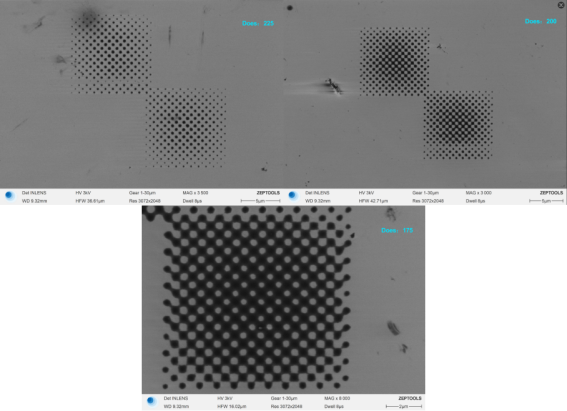
圖2 校正劑量前175、200、225μC/cm2條件下SEM形貌圖
為優(yōu)化中心區(qū)域圖形尺寸不均勻,且與邊緣孤立圖形差異過(guò)大現(xiàn)象,隨即開(kāi)啟軟件進(jìn)行鄰近效應(yīng)修正,通過(guò)劑量校正使整體能量沉積分布更均勻,該軟件同樣以Monte Carlo模型為基礎(chǔ),選上對(duì)應(yīng)的襯底材料、光刻膠類(lèi)型、膜厚等參數(shù)后,對(duì)整體圖形區(qū)域進(jìn)行能量沉積模擬,并分別對(duì)欠曝和過(guò)曝區(qū)域的能量沉積進(jìn)行調(diào)整,將欠曝區(qū)域劑量值提升,過(guò)曝區(qū)域劑量值降低,得到的劑量分布圖形如下圖3所示,靠近欠曝區(qū)域的補(bǔ)償值提升到了1.25以上,而過(guò)曝區(qū)域則被降低至約1.15以下。并依據(jù)上圖2得到的SEM數(shù)據(jù)表現(xiàn)為依據(jù),對(duì)比200μC/cm2和225μC/cm2時(shí)的圖形表現(xiàn)為幾乎整體都能量沉積過(guò)大,進(jìn)行能量沉積校正時(shí)必然導(dǎo)致中心能量不足或最邊緣區(qū)域能量過(guò)大,導(dǎo)致圖形不均勻,因?yàn)樵撥浖{(diào)整原理是按照當(dāng)下劑量為標(biāo)準(zhǔn),調(diào)整中心與邊緣不同曝光區(qū)域位置的能量沉積比例。故此,判斷最佳劑量就應(yīng)當(dāng)處于175μC/cm2附近,并再次進(jìn)行曝光、顯影后,在SEM下觀察得到部分表現(xiàn)較好組別如下圖4所示,其中表現(xiàn)最好的為150μC/cm2劑量的組別,如下圖5所示。
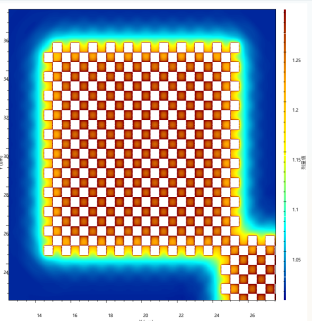
圖3 能量沉積模擬示意圖
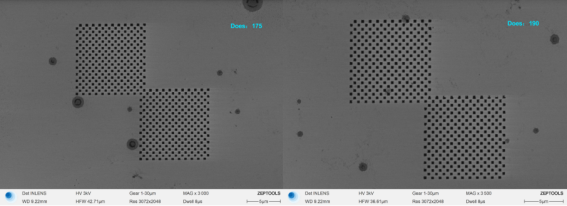
圖4 調(diào)整后175、190μC/cm2下曝光后SEM數(shù)據(jù)形貌圖
結(jié)合上圖中175μC/cm2時(shí)的表現(xiàn)和圖2中未校正前175μC/cm2時(shí)的表現(xiàn),我們可以明顯的看到鄰近效應(yīng)對(duì)電子束光刻的影響異常顯著,修正后圖形大多表現(xiàn)為規(guī)則的方格形,且中心區(qū)域與邊緣區(qū)域圖形尺寸差異不再像調(diào)整之前那樣巨大,整體上表現(xiàn)明顯優(yōu)于未調(diào)整時(shí)的狀態(tài),鄰近效應(yīng)作用得到顯著降低。同樣地,190μC/cm2組別的表現(xiàn)也是中心區(qū)域圖形較為均勻,但中心與邊緣圖形差異略大。但是,上圖中的兩個(gè)劑量下圖形尺寸也僅僅只是靠近中心區(qū)域整體表現(xiàn)較為均勻。
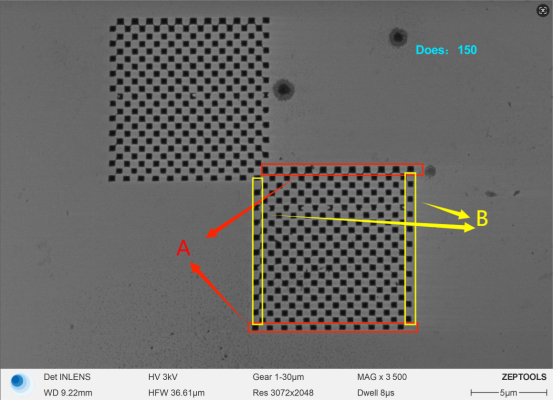
圖5 150μC/cm2組別SEM下形貌圖
對(duì)比圖5與圖4,我們能發(fā)現(xiàn)圖5中心區(qū)域圖形大小一致程度有略微提升,且邊緣孤立圖形與靠近中心區(qū)域的圖形尺寸差異也有更明顯的縮小,但是靠外側(cè)孤立圖形區(qū)域在棋盤(pán)頂部和底部位置的圖形A仍然相比于其它區(qū)域尺寸過(guò)小明顯,而在棋盤(pán)兩測(cè)的孤立圖形區(qū)域處的圖形B,相比于中心區(qū)域則有一定的尺寸過(guò)大,這也表示在A和B區(qū)域的能量沉積仍然存在異常,仍需調(diào)整優(yōu)化。此外,調(diào)整后的對(duì)應(yīng)參數(shù)也對(duì)同類(lèi)型圖形可能有效,圖形若有較大變化則效果不明顯。故此,可知鄰近效應(yīng)優(yōu)化技術(shù)仍然是電子束光刻關(guān)鍵技術(shù)中需要重點(diǎn)攻克的難點(diǎn)之一。
參考文獻(xiàn)
[1] 孫伯文,張力,溫積森,等. 中國(guó)光學(xué)十大進(jìn)展:大尺寸微納光學(xué)器件制造技術(shù)(特邀)[J]. 激光與光電子學(xué)進(jìn)展,2025,62(7):1-19. DOI:10.3788/LOP242539.
[2] 陳寶欽,徐秋霞,謝常青,等. 電子束光刻鄰近效應(yīng)校正技術(shù)[C]//第十六屆全國(guó)半導(dǎo)體集成電路硅材料學(xué)術(shù)會(huì)議論文集. 2009:1-15.
[3] 孫霞,尤四方,肖沛,等. 電子束光刻的鄰近效應(yīng)及其模擬[J]. 物理學(xué)報(bào),2006,55(1):148-154. DOI:10.3321/j.issn:1000-3290.2006.01.027.
[4] 楊清華,劉明,陳大鵬,等. 高斯電子束曝光系統(tǒng)[J]. 電子工業(yè)專(zhuān)用設(shè)備,2005,34(2):42-45. DOI:10.3969/j.issn.1004-4507.2005.02.009.
[5] 錢(qián)俊. 微納加工領(lǐng)域新著--《微納加工及在納米材料與器件研究中的應(yīng)用》[J]. 物理,2013(11):821-821.
[6] 肖沛,孫霞,閆繼紅,等. 電子束光刻中鄰近效應(yīng)校正的幾種方法[J]. 電子顯微學(xué)報(bào),2005,24(5):464-468. DOI:10.3969/j.issn.1000-6281.2005.05.003.
[7] 姚文澤,徐宏成,趙浩杰,等. 電子束光刻"自主可控"EDA軟件HNU-EBL[J]. 湖南大學(xué)學(xué)報(bào)(自然科學(xué)版),2022,49(10):183-191. DOI:10.6339/j.cnki.hdxbzkb.2022239.
作者:澤攸科技
